
0756-8632035
以客户为中心

新闻动态
NEWS
经过前端工艺处理并通过晶圆测试的晶圆将从背面研磨(Back Grinding)开始后端处理。背面研磨是将晶圆背面磨薄的工序,其目的不仅是为了减少晶圆厚度,还在于联结前端和后端工艺以解决前后两个工艺之间出现的问题。半导体芯片(Chip)越薄,就能堆叠(Stacking)更多芯片,集成度也就越高。但集成度越高却可能导致产品性能的下降。所以,集成度和提升产品性能之间就存在矛盾。因此,决定晶圆厚度的研磨(Grinding)方法是降低半导体芯片成本、决定产品质量的关键之一。
1. 背面研磨(Back Grinding)的目的
![]()
图1. 晶圆制造工艺和半导体制造工艺中的形态变化
在由晶圆制成半导体的过程中,晶圆的外观不断发生变化。首先,在晶圆制造工艺中,晶圆的边缘(Edge)和表面会进行抛光(Polishing),这一过程通常会研磨晶圆的两面。前端工艺结束后,可以开始只研磨晶圆背面的背面研磨工序,能去除在前端工艺中受化学污染的部分,并减薄芯片的厚度,这非常适用于制作搭载于IC卡或移动设备的薄型芯片。此外,这一工序还有减少电阻、降低功耗、增加热导率而迅速散热至晶圆背面的优点。但与此同时,由于晶圆较薄,很容易被外力折断或翘曲,使得处理步骤更加困难。
2. 背面研磨(Back Grinding)详细工艺流程

图2. 背面研磨三步骤
背面研磨具体可以分为以下三个步骤:第一、在晶圆上贴上保护胶带贴膜(Tape Lamination);第二、研磨晶圆背面;第三、在将芯片从晶圆中分离出来前,需要将晶圆安置在保护胶带的晶圆贴片(Wafer Mounting)上。晶圆贴片工艺是分离芯片(切割芯片)的准备阶段,因此也可以包含在切割工艺中。近年来,随着芯片越来越薄,工艺顺序也可能发生改变,工艺步骤也愈发精细化。
3. 保护晶圆的贴膜(Tape Lamination)工艺
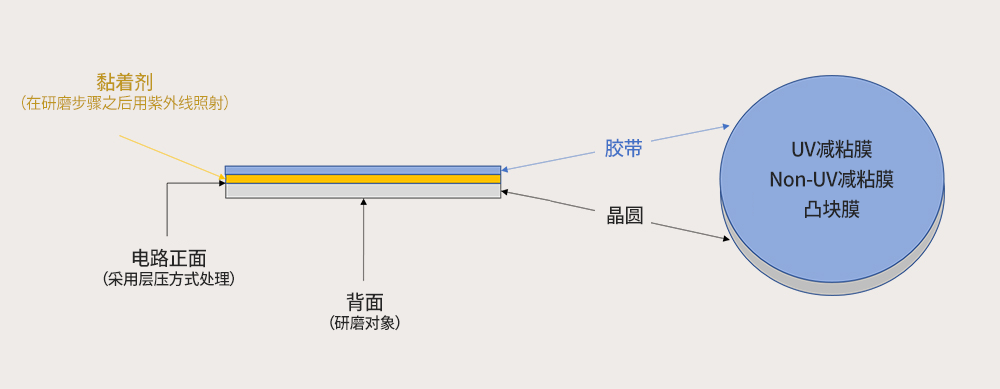
图3. 贴膜工艺和晶圆正面
背面研磨的第一步是贴膜。这是一种将胶带粘到晶圆正面的涂层工艺。进行背面研磨时,硅化合物会向四周扩散,晶圆也可能在这一过程中会因外力而破裂或翘曲,且晶圆面积越大,越容易受到这种现象的影响。因此,在背面研磨之前,需要贴上一条薄薄的紫外线(Ultra Violet, 简称 UV)蓝膜用于保护晶圆。
贴膜时,为了使晶圆和胶带之间没有间隙或气泡,需要提高粘合力。但在背面研磨后,晶圆上的胶带应通过紫外线照射降低粘合力。剥离后,胶带的残留物不得留在晶圆表面。有时,该工艺会使用粘合力较弱且容易产生气泡的非紫外线减粘膜处理,虽然缺点多,但价格低廉。此外,还会用到比UV减粘膜厚两倍的凸块(Bump)膜,预计在未来会有越来越高的使用频率。
4. 晶圆厚度与芯片封装成反比

图4. 多芯片封装(MCP,Multi Chip Package)结构
经过背面研磨的晶圆厚度一般会从800-700㎛减少到80-70㎛。减薄到十分之一的晶圆能堆叠四到六层。近来,通过两次研磨的工艺,晶圆甚至可以减薄到大约20㎛,从而堆叠到16到32层,这种多层半导体结构被称为多芯片封装(MCP)。在这种情况下,尽管使用了多层结构,成品封装的总高度不得超过一定厚度,这也是为何始终追求磨得更薄的晶圆。晶圆越薄,缺陷就会越多,下一道工序也越难进行。因此,需要先进的技术改进这一问题。
5. 背面研磨方法的改变

图5. 根据晶圆厚度而不同的研磨方法
通过将晶圆切割得尽可能薄以克服加工技术的局限性,背面研磨技术不断发展。对于常见的厚度大于等于50㎛的晶圆,背面研磨有三个步骤:先是粗磨(Rough Grinding),再是精磨(Fine Grinding),两次研磨后切割并抛光晶圆。此时,类似化学机械抛光(Chemical Mechanical Polishing,简称 CMP)一样,一般会在抛光垫和晶圆之间投入浆料(Slurry)和去离子水(Deionized Water)。这种抛光工作能减少晶圆和抛光垫之间的摩擦,使表面光亮。当晶圆较厚时,可以采用超精细研磨(Super Fine Grinding),但晶圆越薄,就越需要进行抛光。
如果晶圆变得更薄,在切割过程中容易出现外部缺陷。因此,如果晶圆的厚度为50㎛微米或更小,可以改变工艺顺序。此时,会采用先划片后减薄(DBG,Dicing Before Grinding)的方法,即在第一次研磨之前,先将晶圆切割一半。按照划片(Dicing)、研磨和划片的顺序,将芯片从晶圆安全地分离出来。此外,还有使用坚固的玻璃板来防止晶圆破裂的特殊的研磨方法。
随着电器小型化对集成度的要求越来越高,背面研磨技术也应不但克服其局限性,继续发展。同时,不仅要解决晶圆的缺陷问题,还必须为未来工艺可能出现的新问题做好准备。为了解决这些问题,可能需要调换工艺顺序,或引入应用于半导体前端工艺的化学蚀刻技术,全面开发新的加工方法。为了解决大面积晶圆固有的缺陷,正对研磨方法进行多种探索尝试。此外,关于如何回收利用研磨晶圆后产生的硅渣的研究也正在进行。
源文地址:https://news.skhynix.com.cn/back-grinding-determines-the-thickness-of-a-wafer/#
版权声明: 本站内容除原创文章之外,转载内容只为传递更多信息,并不代表本网站赞同其观点。转载的所有的文章、图片、音/视频文件等资料的版权归版权所有权人所有。本站采用的非本站原创文章及图片等内容无法一一联系确认版权者。如涉及作品内容、版权和其它问题,请及时通过电子邮件或电话通知我们,以便迅速采取适当措施,避免给双方造成不必要的经济损失。联系电话:0756-8632035;邮箱:zhcce@chnchip.com.cn。
珠海市中芯集成电路有限公司是一家专业从事集成电路后序加工的高科技电子公司,可以为客户提供晶圆测试(wafer testing)、晶圆切割Dicing Saw(半切及贴膜全切) 、晶圆研磨减薄(wafer back grinding)、成品测试及tcp/cof/cob封装等全方位的服务。公司是中国半导体行业协会会员,珠海市软件行业协会副会长单位,获授国家高新技术企业,广东省“守合同重信用”企业,通过ISO 9001:2008和ISO 9001:2015体系认证。中芯的行为准则是“以客户为中心,以质量求生存,以服务求发展!”,希望通过我们的专业程度和不懈的努力,为客户提供低成本、高品质的产品。










