
0756-8632035
以客户为中心

新闻动态
NEWS
一个晶圆要经历三次的变化过程,才能成为一个真正的半导体芯片:首先,是将块儿状的铸锭切成晶圆;在第二道工序中,通过前道工序要在晶圆的正面雕刻晶体管;最后,再进行封装,即通过切割过程,使晶圆成为一个完整的半导体芯片。可见,封装工序属于后道工序,在这道工序中,会把晶圆切割成若干六面体形状的单个芯片,这种得到独立芯片的过程被称作做“切单(Singulaton)”,而把晶圆板锯切成独立长方体的过程则叫做“晶片切割(Die Sawing)”。近来,随着半导体集成度的提高,晶圆厚度变得越来越薄,这当然给“切单”工艺也带来了不少难度。
一、晶圆切割(Wafer Dicing)的发展历程

图1. 晶圆切割方法的发展历程(切单)
前道和后道工序通过各种不同方式的互动而进一步发展:后道工序的进化可以决定晶圆上die单独分离出的六面体小芯片)的结构和位置,以及晶片上焊盘(电连接路径)的结构和位置;与之相反,前端工艺的进化则改变了后端工艺中的晶圆背面减薄和“晶片切割(Die Sawing)”晶圆的流程和方法。因此,封装的外观日益变得精巧,会对后端工艺带来很大的影响。而且,根据包装外观的变化,切割次数、程序和类型也会发生相应的变化。那么,现在就让我们一起通过芯片“切单”的演化过程,来看看五种切割方法吧。
二、划片切割(Scribe Dicing)

图2. 早期的划片切割法:划片后进行物理上的分割(Breaking)@直径为6英寸以下的的晶圆
早期,通过施加外力切割的“掰开(Breaking)”是唯一可以把晶圆分割成六面形的Die的切割法。然而,这种方法却存小芯片边缘剥落(Chipping)或产生裂纹等弊端。而且,由于没有完全去除金属表面的毛刺(Burr:切割时产生的一些残渣),所以切割表面也非常粗糙。
为了解决这一问题,“划片(Scribing)”切割法应运而生,即在“掰开(Breaking)”前,将晶圆表面切割至大约一半的深度。“划片”,顾名思义,是指使用叶轮在晶圆的正面事先锯切(半切)。早期,6英寸以下的晶圆大部分都使用了这种现在芯片之间先“划片”,再“掰开(Breaking)”的切割法。
三、刀片切割 (或锯切) (Blade Dicing or Blade Sawing)
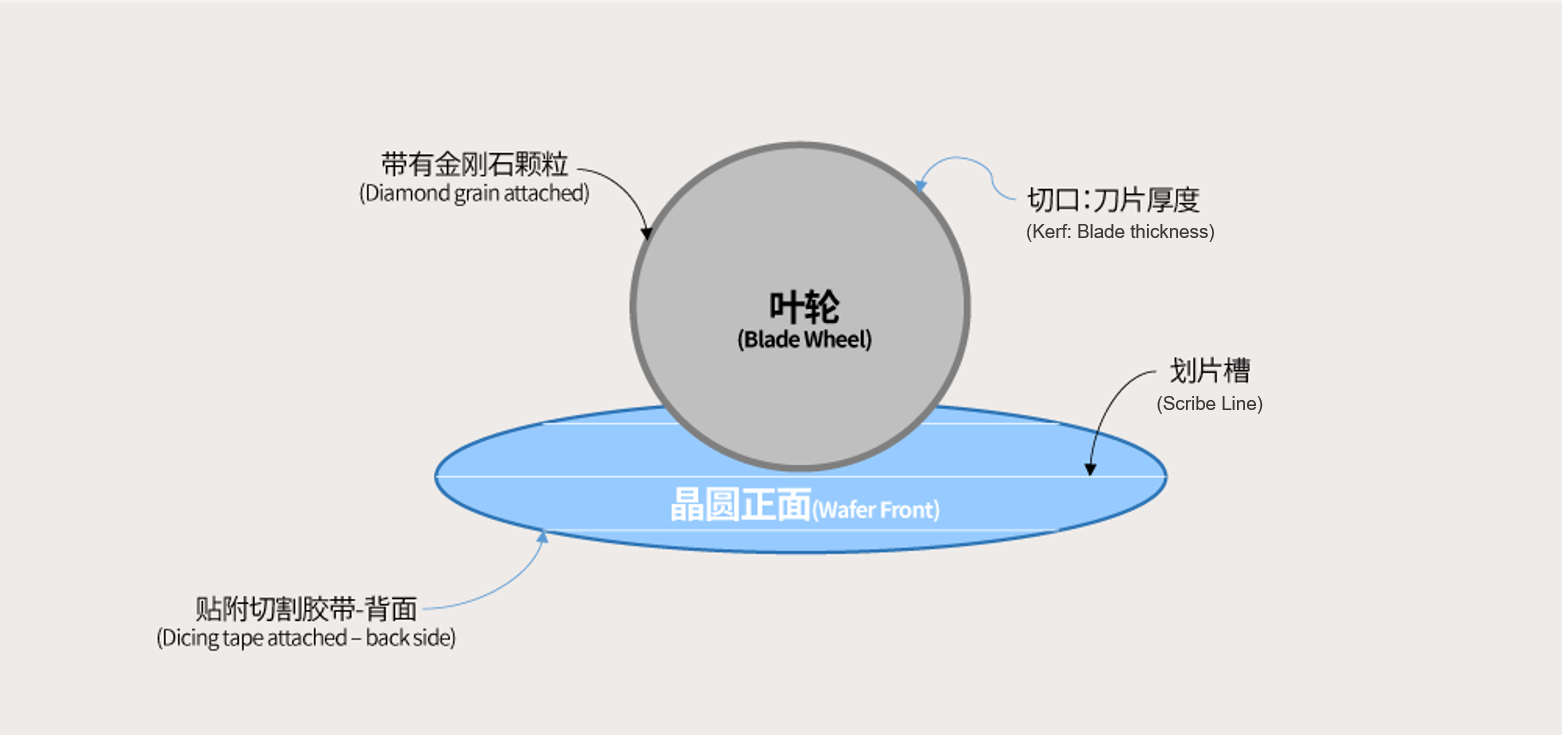
图3-1. 刀片切割(锯切)方法@传统方法
“划片”切割法逐渐发展成为“刀片(Blade dicing)”切割(或锯切)法,即连续使用刀片两到三次进行切割的方法。“刀片”切割法可以弥补“划片”后“掰开(Breaking)”时,小芯片剥落的现象,可在“切单(Singulation)”过程中起到保护小芯片的作用。“刀片”切割与之前的“划片”切割有所不同,即进行完一次“刀片”切割后,不是“掰开(Breaking)”,而是再次用刀片切割。所以,也把它称为“分步切割(Step Dicing)”法。

图3-2. 刀片切割(锯切)过程中,保护膜的附着与摘除
为了保护晶圆在切割过程中免受外部损伤,事先会在晶圆上贴敷胶膜,以便保证更安全的“切单”。“背面减薄(Back Grinding)”过程中,胶膜会贴在晶圆的正面。但与此相反,在“刀片”切割中,胶膜要贴在晶圆的背面。而在共晶贴片(Die Bonding,把分离的芯片固定在PCB或定架上)过程中,贴会背面的这一胶膜会自动脱落。切割时由于摩擦很大,所以要从各个方向连续喷洒DI水。而且,叶轮要附有金刚石颗粒,这样才可以更好地切片。此时,切口(刀片厚度:凹槽的宽度)必须均匀,不得超过划片槽的宽度。
很长一段时间,锯切一直是被最广泛使用的传统的切割方法,其最大的优点就是可以在短时间内切割大量的晶圆。然而,如果切片的进给速度(Feeding Speed)大幅提高,小芯片边缘剥落的可能性就会变大。因此,应将叶轮的旋转次数控制在每分钟30000次左右。可见,半导体工艺的技术往往是通过很长一段时间的积累和试错,慢慢积累的秘诀(在下一节有关共晶贴片的内容上,将讨论有关切割与DAF的内容)。
四、先切割、后减薄 (DBG,Dicing Before Grinding): 切割顺序改变了方法

图4. 现存的刀片切割&DBG(先切割,后减薄)方法
在直径为8英寸晶圆上进行刀片切割时,不用担心小芯片边缘剥落或裂纹等现象。但随着晶圆直径增加至21英寸,且厚度变也得极薄,剥落与裂纹现象又开始出现了。为了大幅减少在切割过程中对晶圆的物理冲击,“先切割、后研磨”的DBG方法取代了传统的切割顺序。 与连续进行切割的传统“刀片”切割法不同,DBG先进行一次“刀片”切割后,就通过不断的背面减薄使晶圆厚度逐渐变薄,直到芯片分裂为止。可以说,DBG时以往“刀片”切割法的升级版,因为它可以减少第二次切割带来的冲击,所以,DBG方法在“晶圆级封装”上得到了迅速的普及。
五、激光切割(Laser Dicing)
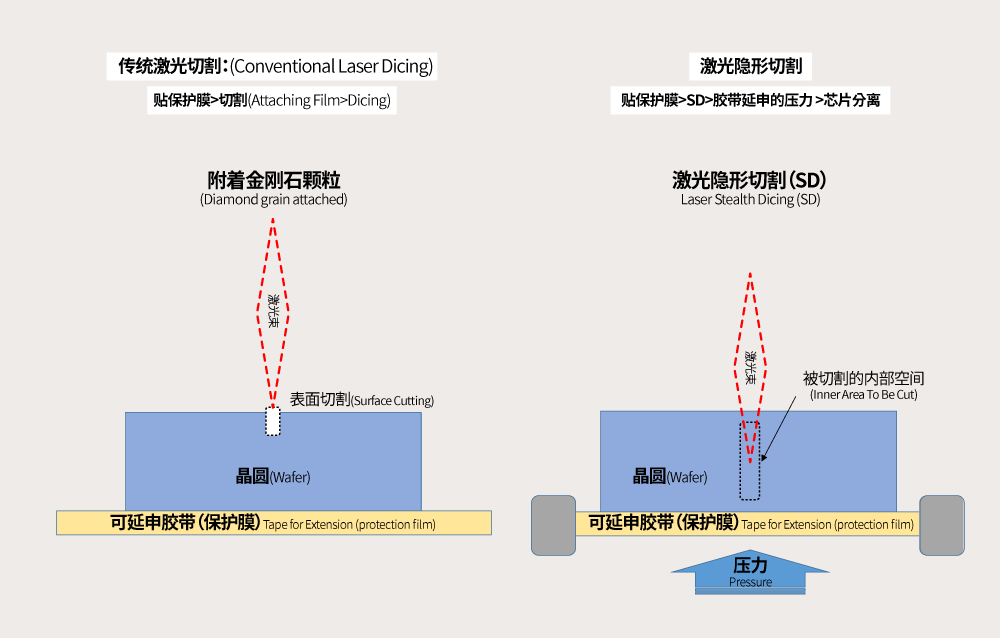
图5. 传统激光切割(grooving)&激光隐形切割(SD)方法的比较
晶圆级晶片尺寸封装(WLCSP,Wafer Level Chip Scale Package)工艺主要采用激光切割法。采用激光切割可以减少剥落和裂纹等现象,从而获得更优质的芯片,但晶圆厚度为100μm以上时,生产率将大打折扣。所以,多用在厚度不到100μm(相对较薄)的晶圆上。激光切割是通过在晶圆的划片槽上施加高能量的激光来切割硅。但使用传统的激光(Conventional Laser)切割法,要在晶圆表面上事先涂层保护膜。因为,在晶圆表面加热或照射激光等,这些物理上的接触会晶圆表面会产生凹槽,而且切割的硅碎片也会粘附在表面上。可见,传统的激光切割法也是直接切割晶圆表面,在这一点上,它与“刀片”切割法有相似之处。
激光隐形切割(SD, Stealth Dicing)则是先用激光能量切割晶圆的内部,再向贴附在背面的胶带施加外部压力,使其断裂,从而分离芯片的方法。当向背面的胶带施加压力时,由于胶带的拉伸,晶圆将被瞬间向上隆起,从而使芯片分离。相对传统的激光切割法SD的优点为:一是没有硅的碎屑;二是切口(Kerf:划片槽的宽度)窄,所以可以获得更多的芯片。此外,使用SD方法剥落和裂纹现象也将大大减少,这至关定切割的整体质量。因此,SD方法非常有望成为未来最受青睐的一项技术。
六、等离子切割(Plasma Dicing)
等离子切割作时最近发展起来的一项技术,即在制造(Fab)过程中使用等离子蚀刻的方法进行切割。等离子切割法用半气体材料代替了液体,所以对环境影响相对较小。而且采用了对整个晶圆一次性切割的方法,所以“切单”速度也相对较快。然而,等离子方法要以化学反应气体为原料,且蚀刻过程非常复杂,因此其工艺流程相对较繁琐。但与“刀片”切割、激光切割相比,等离子切割不会给晶圆表面造成损伤,从而可以降低不良率,获得更多的芯片。
近来,由于晶圆厚度已减小至30μm,且使用了很多铜(Cu)或低介电常数等材料(Low-k )。因此,为了防止毛刺(Burr),等离子切割方法也将受到青睐。当然,等离子切割技术也在不断的发展中,相信不久的将来,终有一天蚀刻时可以不再需要佩戴专用口罩,因为这就是等离子切割的一大发展方向。
随着晶圆的厚度从100μm到50μm、再到30μm、不断变薄,获得独立芯片的切割方法也从“掰开(breaking)”、“刀片”切割,到激光切割,再到等离子切割,不断变化发展着。日趋成熟的切割方法,虽然带来了切割工艺本身生产成本的增加,但另一方面,通过大幅减少半导体芯片切割中经常出现的剥落、裂纹等不良现象和单位晶圆上芯片获得量的增多,单个芯片的生产成本反而却呈现出下降趋势。当然,晶圆单位面积芯片获得量的增加,与划片槽(Dicing Street宽度)宽度的缩小有着密切的关系。采用等离子切割法,相对采用“刀片”切割法,可以获得将近20%的更多的芯片,这也是为什么人们选择等离子切割法的一大原因。随着晶圆、芯片外观和封装方法的发展变化,晶圆加工技术和DBG等各种切割工艺也正在应运而生。
源文地址:https://news.skhynix.com.cn/singulation-the-moment-when-a-wafer-is-separated-into-multiple-semiconductor-chips/
版权声明: 本站内容除原创文章之外,转载内容只为传递更多信息,并不代表本网站赞同其观点。转载的所有的文章、图片、音/视频文件等资料的版权归版权所有权人所有。本站采用的非本站原创文章及图片等内容无法一一联系确认版权者。如涉及作品内容、版权和其它问题,请及时通过电子邮件或电话通知我们,以便迅速采取适当措施,避免给双方造成不必要的经济损失。联系电话:0756-8632035;邮箱:zhcce@chnchip.com.cn。
珠海市中芯集成电路有限公司是一家专业从事集成电路后序加工的高科技电子公司,可以为客户提供晶圆测试(wafer testing)、晶圆切割Dicing Saw(半切及贴膜全切) 、晶圆研磨减薄(wafer back grinding)、成品测试及tcp/cof/cob封装等全方位的服务。公司是中国半导体行业协会会员,珠海市软件行业协会副会长单位,获授国家高新技术企业,广东省“守合同重信用”企业,通过ISO 9001:2008和ISO 9001:2015体系认证。中芯的行为准则是“以客户为中心,以质量求生存,以服务求发展!”,希望通过我们的专业程度和不懈的努力,为客户提供低成本、高品质的产品。











